
掃碼加微信

熱門關鍵詞:展至科技 氧化鋁陶瓷基板/支架 氮化鋁陶瓷基板/支架 陶瓷覆銅板 陶瓷電路板
隨著國內外LED行業(yè)向高效率、高密度、大功率等方向發(fā)展,從2016到2019就能看出,整體國內LED有了快速發(fā)展,如今功率也是越來越大,在開發(fā)性能優(yōu)越的散熱材料已經成為LED散熱問題的解決,也是當務之急。為了使LED結溫保持著較低溫度下,然而必須采用高導熱率、低熱阻的散熱基板材料和合理的封裝工藝,從而以降低LED總體的封裝熱阻。
如今現(xiàn)代通訊技術的發(fā)展,在多層陶瓷基板上憑借著其靈活布線、三維集成等優(yōu)勢廣泛應用于航空航天、衛(wèi)星通訊等射頻領域。為了實現(xiàn)電子整機向高密度,小型化,輕量化的方向發(fā)展,現(xiàn)在越來越多的電路組件使用多層陶瓷基板一體化封裝技術來實現(xiàn)模塊化和器件化。

研究AIN多層陶瓷基板一體化封裝技術,AIN多層陶瓷相比較于低溫共燒陶瓷和AI2O3共燒陶瓷來講,其中導熱系數高,熱膨脹系數和Si更接近。
在伴隨著電子設備的集成度大幅提高,電路中單位面積所散發(fā)出來的熱量不斷增大,系數對散熱要求也越來越高。
AIN一體化封裝工藝結構
1、AlN基板制備流程
AIN多層陶瓷基板制備流程與傳統(tǒng)低溫共燒陶瓷工藝流程基本一致,由于材料體系和成分差別,與個別工藝略有不同。在實驗陶瓷材料采用厚度為0.13mm高純氮化鋁膜帶,通孔金屬漿料和印刷漿料均選擇高溫燒結鎢漿,一般AlN燒結需要在還原氣氛下進行;排膠和燒結是AlN多層陶瓷基板制備流程中的關鍵工序,影響著基板的翹曲、開裂等,直接決定了多層板的性能和質量。陶瓷基板表面共燒的鎢漿無法直接進行焊接、鍵合且極易氧化,需要在表層進行化鍍鎳鈀金進行后續(xù)裝配。
2、AlN一體化封裝結構
AlN多層陶瓷基板的一體化封裝主要由以下幾部分組成:AlN多層陶瓷基板,圍框和蓋板,具體結構如圖1所示。
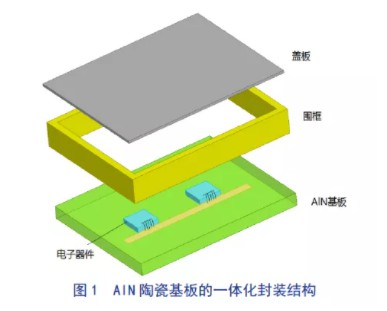
圍框一般采用焊接溫度較高的焊料與基板焊接,對于整體結構而言,圍框材質的熱膨脹系數需要與基板熱膨脹系數接近,以防在焊接時熱應力失配造成產品開裂。蓋板與圍框多采用平行縫焊的方式進行氣密封裝。
氮化鋁陶瓷基板一體化封裝工藝流程
1.一體化封裝材料 2.圍框焊接及測試 3.氣密封焊及測試
