
掃碼加微信

熱門關鍵詞:展至科技 氧化鋁陶瓷基板/支架 氮化鋁陶瓷基板/支架 陶瓷覆銅板 陶瓷電路板
電動汽車和混合動力汽車的共同設計目標是最小化電子元件的尺寸,這就是導致了在更高功率水平下使用更小功率模塊的趨勢,這總是會導致熱問題。即使是最高效率的功率半導體也會產生熱能,這是電流通過有源器件(比如IGBT或MOSFET)時的副產品。為了確保可靠性和較長的使用壽命,必須去除熱量,這可以通過使用具有高導熱性的陶瓷電路基板材料(例如陶瓷基板)來有效地實現。

在必須為給定設備管理的熱量將是設備產生的功率的函數,更高的功率水平會產生更多熱量。DBC和AMB陶瓷基板具有不同的熱導性,例如熱阻(Rth)和熱導率,這可以作為指導哪種材料更適合不同功率水平的指南。例如,在+20℃時,氧化鋁(AI2O3)的熱導率為24W/mk,而氮化硅(Si3N4)的熱導率為90W/mk。
但對于氮化鋁,其導熱率為170W/mk,這使其成為必須不惜一切代價散熱的極高功率、高功率密度電路的明確選擇。當需要低熱阻來散發大量熱量時,這也可以通過減小陶瓷基板的厚度來實現。
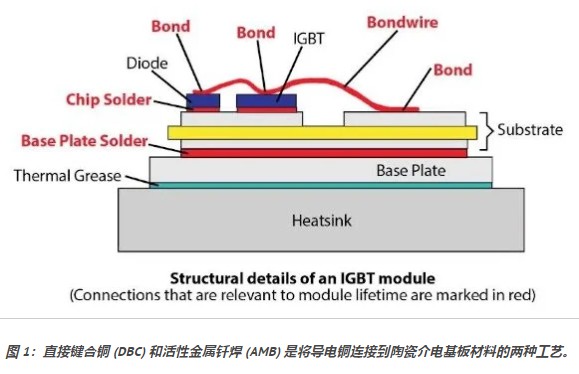
在為EV和HEV尋找電源電路陶瓷基板材料時,要考慮的另一個與材料相關的參數是熱膨脹系數(CTE),它描述了不同材料如何隨溫度膨脹和收縮。由于材料的特定熱導率,與兩種不同CTE物理連接的兩種材料會在溫度發生較大變化時承受應力。最佳情況下,應盡量減少CTE中的任何失配,例如硅IGBT或MOSFET及其電路基板的失配,以減少兩種不同材料界面處由熱引起的機械應力。

幸運的是,陶瓷基板的低CTE(氧化鋁為6.8ppm/K,氮化硅為2.5ppm/K,氮化鋁為4.7ppm/K)與硅晶體管芯片的低CTE(約2.6ppm/K)兼容。通過形成由陶瓷和銅組合而成的器件引線框架,其CTE低于由裸銅制成的引線框架。使用低CTE陶瓷有阻于補償用于芯片連接的硅芯片和芯片焊料(CTE約為22ppm/K)之間的CTE不匹配。
