
掃碼加微信

熱門關鍵詞:展至科技 氧化鋁陶瓷基板/支架 氮化鋁陶瓷基板/支架 陶瓷覆銅板 陶瓷電路板
陶瓷和銅的“結晶”
陶瓷和金屬往往給人特性相反的印象——廣義上,陶瓷屬于“無機非金屬材料”,更加從側面印證了它們的大相徑庭。

散熱快、絕緣、高硬度 高導熱、導電、延展性
但是材料科學家們并不想放棄各自的巨大優勢,反而開發了陶瓷金屬化的工藝,這對強強聯合“夢幻組合”正在半導體封裝基板上大放異彩。
如果芯片是尖端科技的“指揮官”,那圍繞著芯片的封裝材料就像鋼鐵俠的戰衣——一邊保護“指揮官”免受傷害,一邊最大限度發揮其專長。其中,封裝基板用于承載芯片,起著將芯片與母板連結的關鍵作用。

陶瓷“恪盡職守”,以高導熱、耐高溫、較低的熱膨脹系數、高強度、耐腐蝕以及高絕緣、抗輻射等優勢,使芯片獲得更堅實的保護和更優的熱管理;金屬則需要“肩負連結任務”,薄薄一層覆在陶瓷表面上,使其導電,再利用金屬引線等的焊接實現與母板的結合:陶瓷和金屬能有多“親密”,直接關系到密封效果。
“索性硬上”是方法之一,直接銅鍵合(Direct Copper Bonding - DCB)法將純銅直接熔焊至氧化鋁上,工序簡單,從而成本友好,早在上世紀六七十年代就獲得關注,迄今仍得到廣泛應用。
但在5G、智能物聯、新能源、電動汽車等蓬勃發展的今天,半導體芯片功率不斷提升,輕量化、高集成化的趨勢愈發明顯,也對封裝提出了更嚴苛的要求。
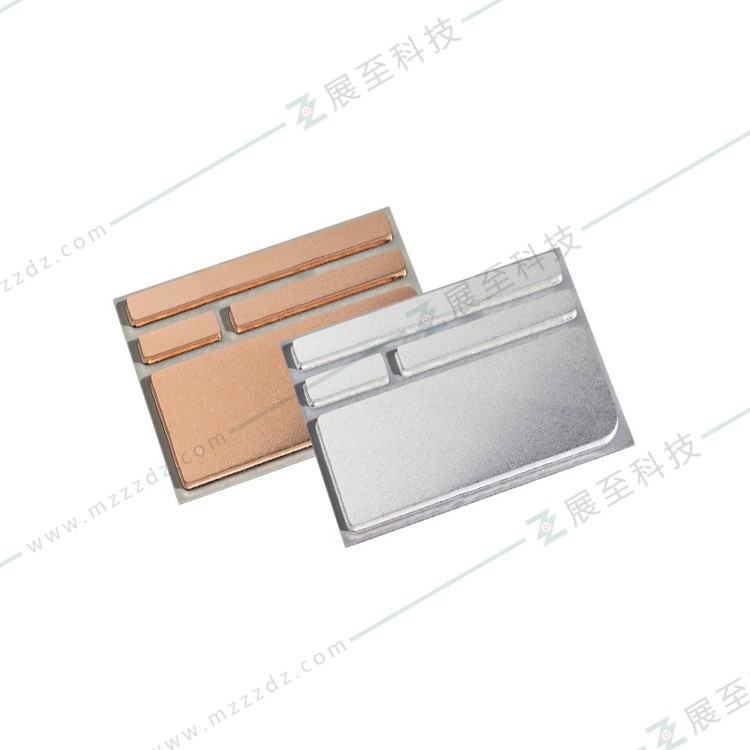
活性金屬釬焊(Active Metal Brazed - AMB)技術發展于DCB的基礎上,以性能大幅提升的氮化硅陶瓷替代氧化鋁,更在陶瓷和純銅之間增加活性金屬釬料,采用高溫真空釬焊,需要額外的絲印工藝和蝕刻工藝。但AMB陶瓷基板的優勢也更加明顯,它不僅具有更高的熱導率、更好的銅層結合力,還實現熱阻更小、可靠性更高,也讓其成為電動汽車、軌道交通、光伏逆變、風力發電、智能電網等大功率、大電流器件的不二選擇。
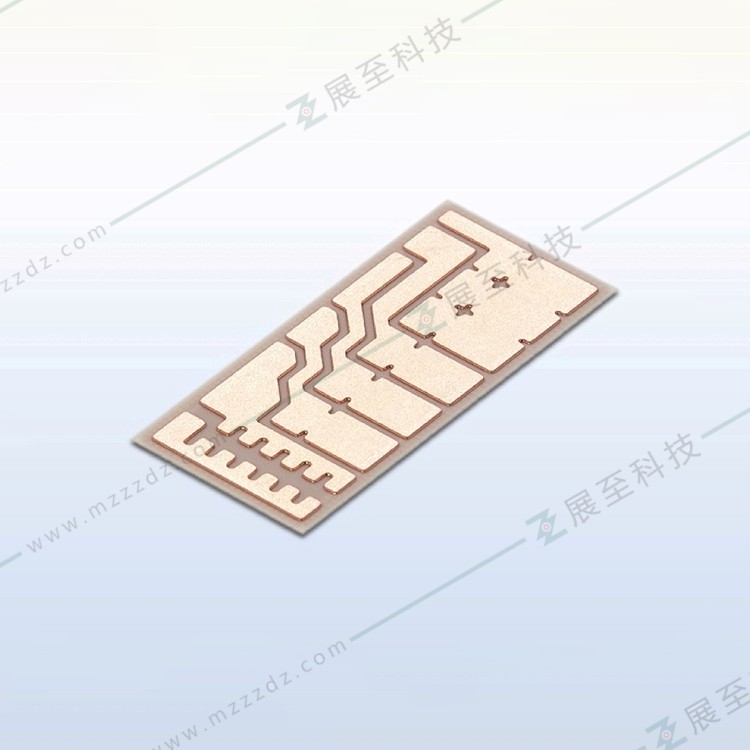
展至電子擁有豐富的DCB和AMB經驗,進而持續精進,在材料和工藝上實現雙重創新,研發出極大限度的提高可靠性和成本效益的新產品活性金屬釬焊(AMB)氮化硅基板。
